High-Speed Ellipsometer 2D Film Thickness Measurement System
ME-210 / ME-310
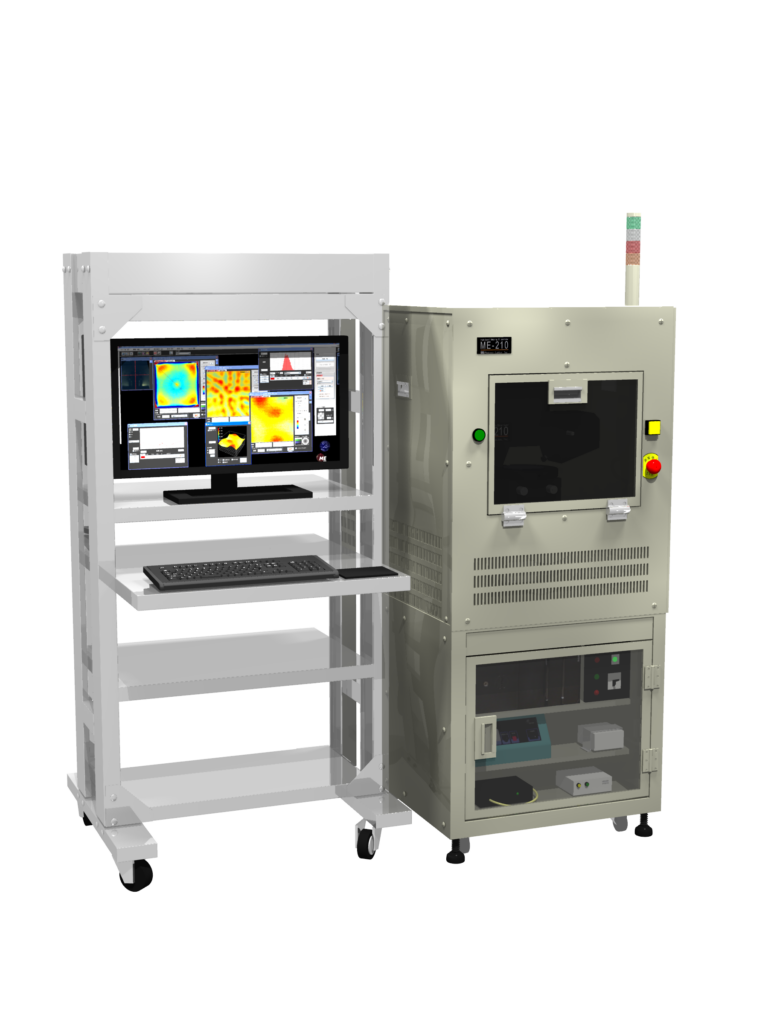
ME-210/ME-310 2D scan allows to measure the film thickness changes of less than 1 nm
at high speed and high density. Support size up to φ12 inches (300 mm) wafer.
Various functions / options to support film thickness measurement.
・compatible with transparent substrates
・zoom & high resolution measurement
|
|
| Repeatability |
|
| Speed |
|
| Light source |
|
| Spot size |
|
| Incident angle |
|
| Dimensions (W x D x H) |
|
| Transparent substrate measurement |
|
|
|
| Sample stage size |
|
| Dimensions (W x D x H) |
|
| Weight |
|
|
|
| Interface |
|
| Power supply |
|
| Software |
|
| Accessories |
|


