High-speed, non-destructive, high-accuracy measurement of thin film thickness & refractive index
We support quality control management with a massive data and various analysis functions.
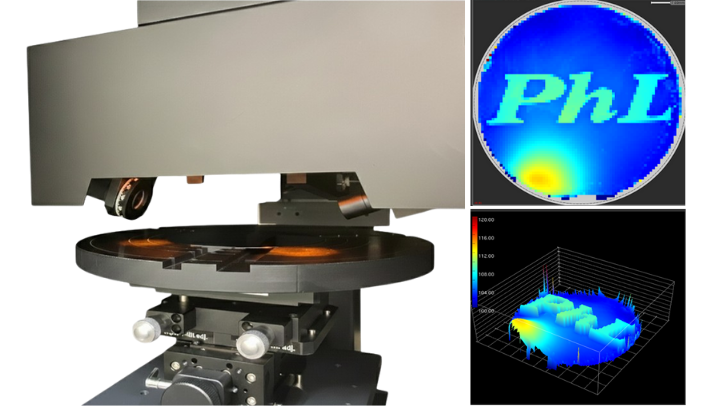

ME/SE Series Film thickness measurement system
ME is a 2D thickness measurement system.
・detect a film thickness of less than 1nm with a high precision
・capable of full-surface scan. up to 12inch (300 mm) wafer
・Specialize in ultra thin films such as resist and native oxide
SE is one point measurement system.
・compact size, easy operation, low price.
・detachable unit. can be built into the production lines and research laboratories.
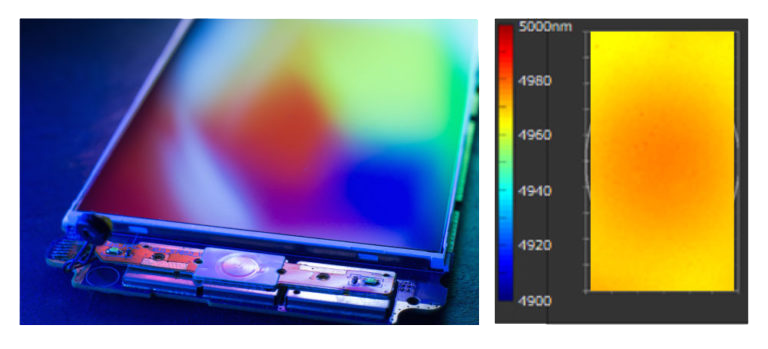
Transparent substrate (Option)
Use for glass substrates
・quality control of thin films on the glass substrates.
Use for spin-coated resist
・detects the thickness of less than 1 nm.
Scan speed 900 points/min allows a full-surface measurement very fast.
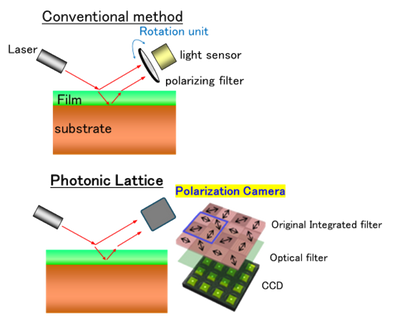
Polarization Camera system
ME/SE Series is an ellipsometer with a polarization sensor. It is an original technology. Unlike conventional methods, no need a polarization filter and rotation mechanisms. ・hardware is small and lightweight. ・With the advantage of the camera speed, we achieve a high-speed real-time measurement Full-surface measurement is a continuing requirement from the manufacturing processes. ・film thickness evaluation from "point" to "surface."
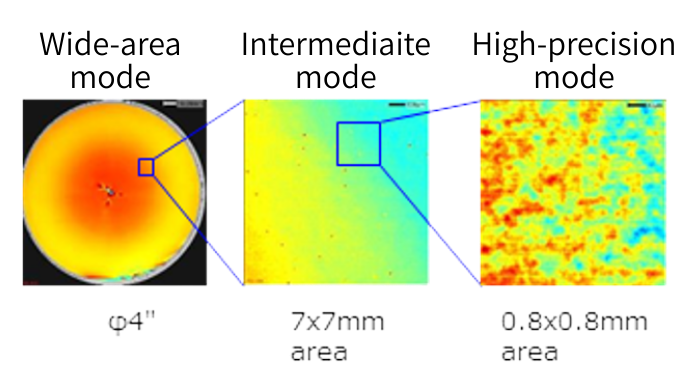
Zoom & High precision measurement
Measurement size up to 12inch wafer.
Zoom function:measure minute areas with high precision
Measurement spot size
・wide-area mode :□ 0.55 mm
・Intermediate mode :□ 55μm
・High-Precision mode:□ 5.5μm
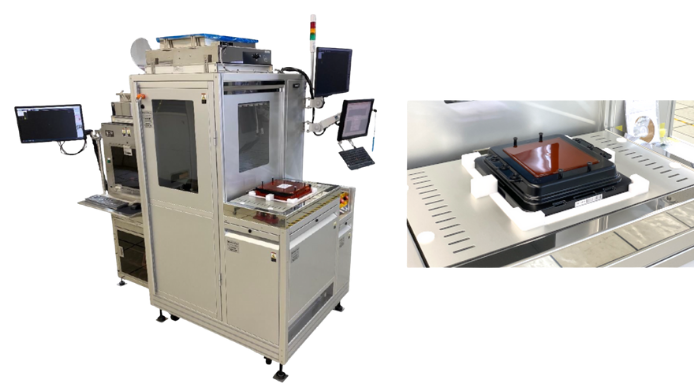
SMIF pods is available for full automation
Compatible with standard SMIF pods. Automatic open/close and transport mechanisms enable fully automated measurements.

Measuring time
4inch (100mm) wafer
□ 2mm width interval ➡ 3 min
Large width interval for a short time measurement
measuring many sheets for the trend analysis
□ 0.5 mm width interval ➡ 33 min
Smaller width interval for a high-quality image
for research institution to obtain detail distribution.
Case

Resist film on a mask blank
It has been difficult to quantitatively measure
the film thickness distribution of ultra-thin films in a microscopic area.
ME can measure the surface distribution of ultra-thin films of
just a few nanometers at any position on the wafer.
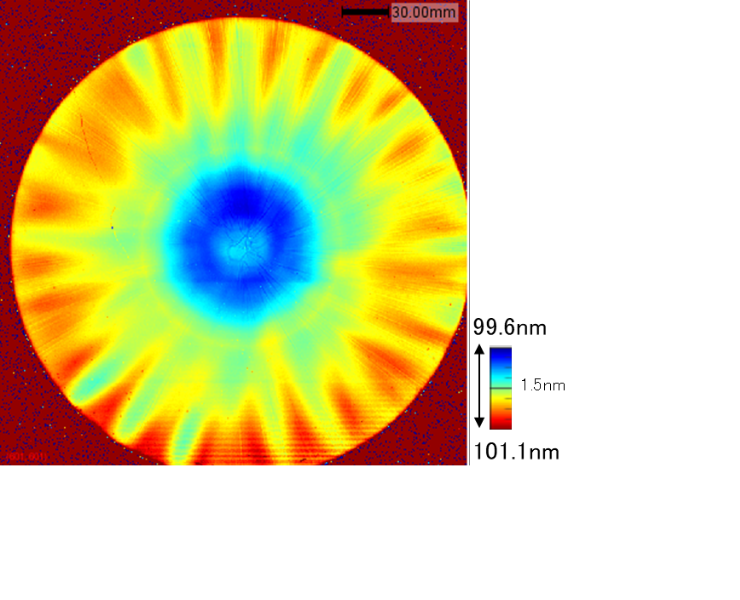
Spin-coated resist film
High-resolution imaging of ultra thin films
Wafer size: 4 inch φ
Measure point: 31,400
Measure time : 34 min
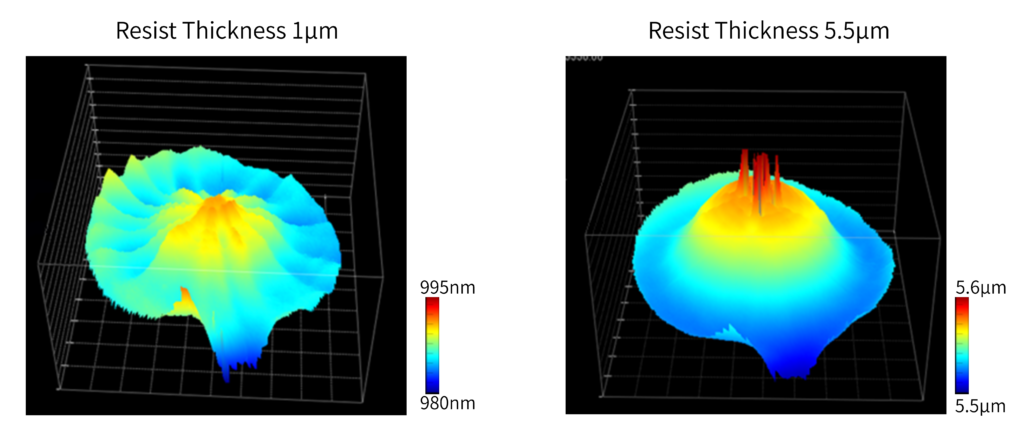
Spin-coated resist film(3D)
Wafer size: 6 inch φ
Measure point: 22,500
Measure time : 22 min

Data Analysis

Other tools
・statistical analysis (average, standard deviation)
・CSV output available
Movie of ME-View basic operation
※with English voice、English subtitle
