高速エリプソメータ2次元分布測定計測装置
ME-210 / ME-310
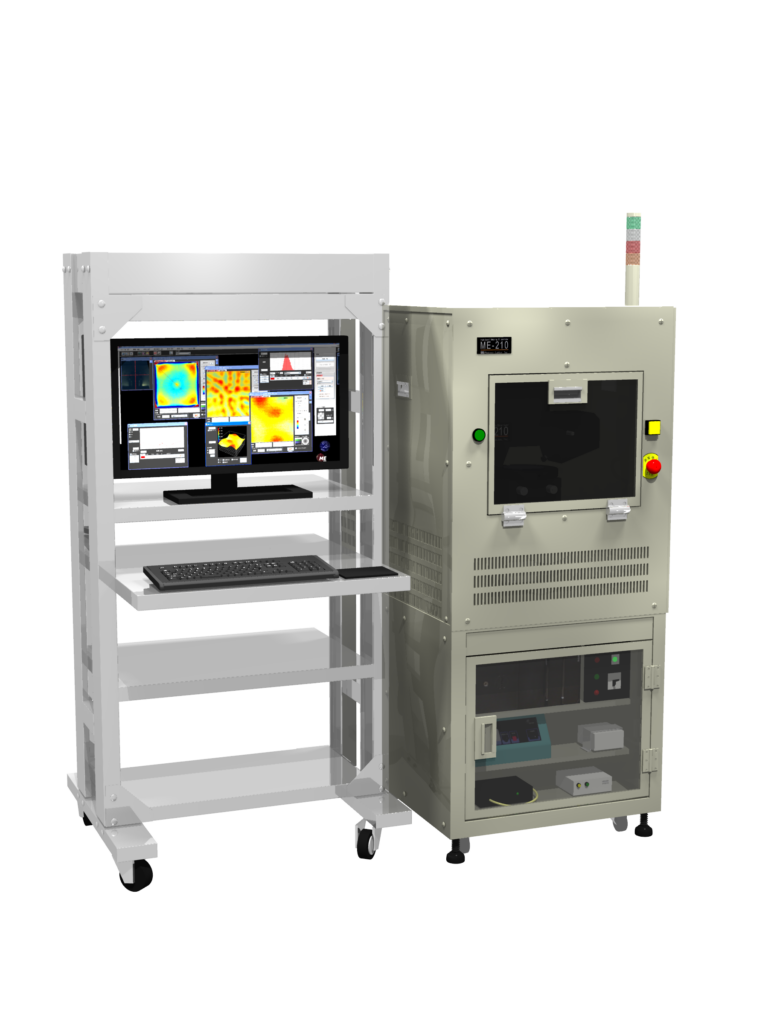
1nm以下の膜厚変化を高速・高密度に面測定できます。
最大 φ12インチ(300mm)ウエハまで対応可能です。
また、透明基板対応、微小領域の拡大・高解像測定など豊富な機能を揃えています。
|
|
| 繰返し再現性 |
|
| 測定速度 |
|
| 光源 |
|
| 測定スポット |
|
| 入射角度 |
|
| 寸法 (W x D x H) |
|
| 透明基板対応 |
|
|
|
| ステージサイズ |
|
| 寸法 (W x D x H) |
|
| 重量 |
|
|
|
| インターフェース |
|
| 電源 |
|
| ソフトウェア |
|
| 付属品 |
|


