薄膜の厚み/屈折率を非接触・非破壊測定を高速・高精度・高精細に測定可能
圧倒的な情報量・豊富な解析機能で品質管理をサポートします。
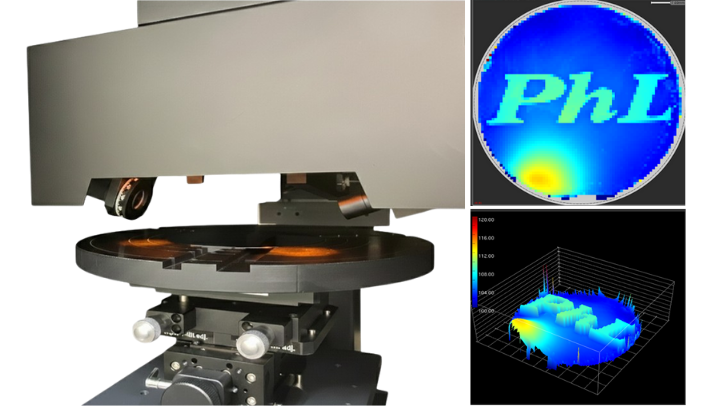

ME/SEシリーズ 膜厚測定
MEシリーズは、1nm以下の膜厚変化を高速に面測定できる装置です。
最大 12インチ (300mm)ウエハまで全面測定可能な高速マッピングエリプソメーターです。
レジスト膜厚、自然酸化膜測定に有効です。
SEシリーズは、低価格、コンパクト、簡易操作性が特徴です。
ヘッドユニットは着脱分解可能で、製造ラインや試験設備への組込みが容易です。
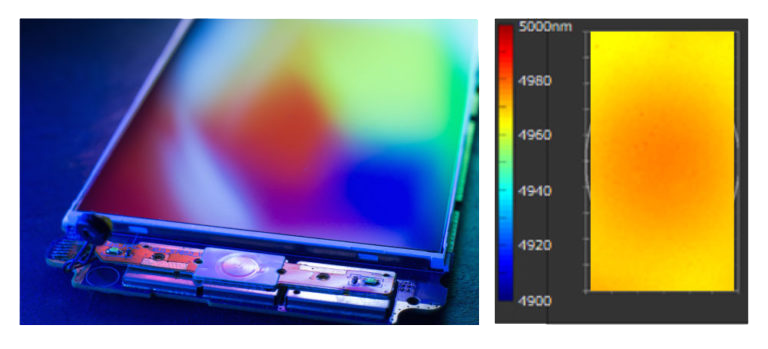
透明基板対応 (オプション)
透明基板対応のMEシリーズ。 ガラス基板上の薄膜の品質管理、プロセス開発の強力支援ツールです。 スピンコートしたレジスト塗布の微小な膜厚ムラに対して、 1nm以下の膜厚変化を検出できます。毎分900点の超高速測定により、 全面測定でプロセス律速になりません。
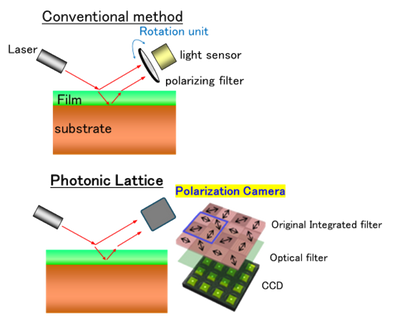
偏光センサー 内蔵カメラ
ME/SEシリーズは、独自技術に基づく偏光センサーを組み込んだエリプソメータです。
従来方式とは異なり偏光フィルタと回転機構は不要です。これにより小型軽量かつ、高速測定を実現しました。カメラ特性を生かして、高速リアルタイム測定を実現します。
膜厚評価を「点」から「面」に、製造プロセスに求めらる全面測定を可能にします。
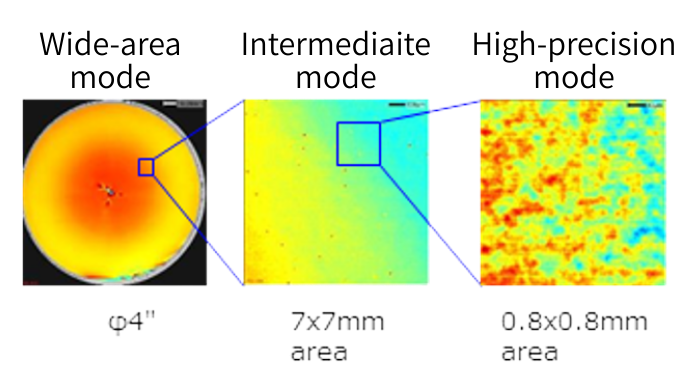
拡大・高解像測定
最大12インチのシリコンウエハ等の膜厚分布を「全面測定」可能です。
領域指定することで「微小領域」を高精細測定が可能です。
測定スポットサイズ
広域モード :□ 0.55 mm
中間モード :□ 55μm
高精細モード :□ 5.5μm
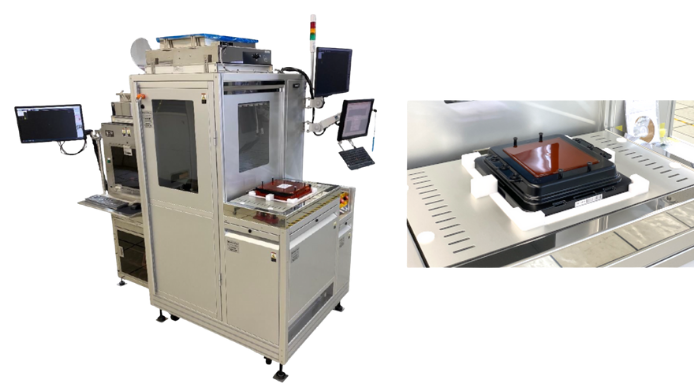
SMIFポッド対応 全自動化
標準仕様のSMIF ポッド対応。
自動開閉機構と自動搬送機構により、全自動測定を実現

測定時間
4インチ(100mm)ウエハの場合
□2mm間隔 ➡ 約3分
測定間隔を粗めにすることで、短時間測定を実現
多数枚の測定や大まかな傾向評価に好適です
□0.5mm間隔 ➡ 約33分
R&Dなどで詳細な分布を取得したい場合は、測定間隔を小さく設定
画像品質の高い膜厚分布データが取得できます
事例

マスクブランクスのレジスト膜
極薄膜の膜厚分布を、微小領域で定量測定することは、
これまで大変困難でしたが、MEシリーズはウェハ内の
任意位置で数nm程度の極薄膜でも面分布測定できます。
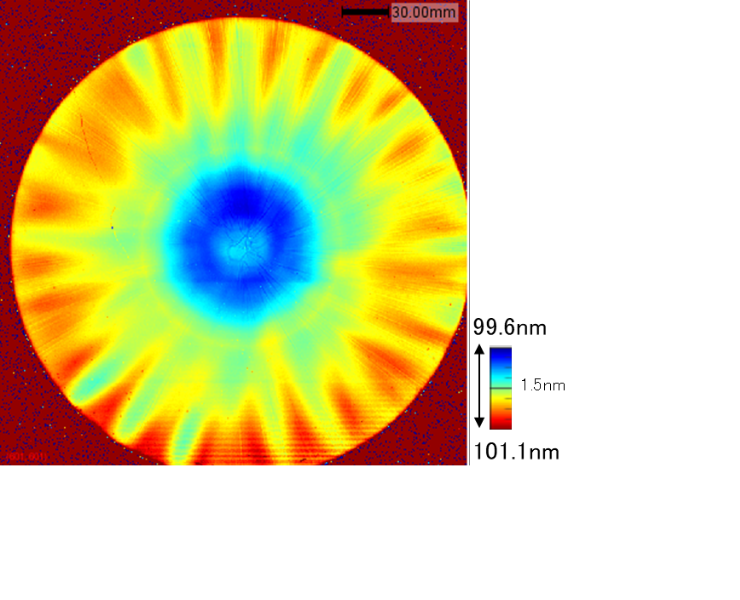
スピンコートしたレジスト膜
僅かな膜厚分布を高精細に可視化できます。
測定範囲: 4インチφ
測定点数: 31,400 ポイント
測定時間: 34分
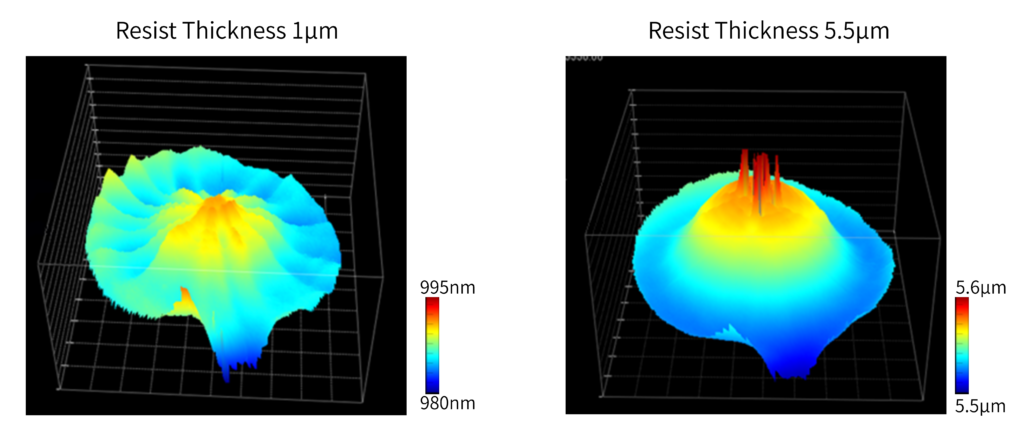
スピンコートしたレジスト膜(3D)
測定範囲: 6インチφ
測定点数: 22,500 ポイント
測定時間: 22分

データ解析

他の解析機能
統計値解析 (平均標準偏差)
csv出力可能
ME-Viewの基本操作方法動画
※英語音声、英語字幕付き
